Стандартният процесор има три основни части. Това са субстратът, матрицата на процесора и IHS. Субстратът е печатната платка, върху която е поставена останалата част от процесора. Той има щифтове на конектора на гнездото на процесора от долната си страна. ЦП матрицата е действителният процесор. Това е прецизно гравиран силиций, който извършва обработката. CPU матрицата също така разполага с нива на CPU кеш, директно интегрирани за минимизиране на времето за комуникация. IHS е интегриран разпределител на топлина. Той се притиска директно върху матрицата на процесора и предава топлината, която произвежда, към охладителя на процесора. IHS също предлага защита срещу напукване на матрицата. Матрицата на процесора е доста крехка и нарастващото налягане на охладителя на процесора може да го спука. IHS неутрализира този риск, тъй като не предава този натиск към матрицата на процесора.
Многочипови модули
Субстратът на пакета осигурява цялата свързаност за матрицата на процесора, насочвайки електрическите сигнали от всеки от използваните щифтове към матрицата на процесора. За съжаление, това не работи толкова добре, когато има няколко матрици на един процесор. Това може да се дължи на факта, че те използват стандартна чиплетна архитектура или защото дизайнът на чипа е по-сложен. Например, това би се приложило и ако процесорът разполага с FPGA или памет директно върху опаковката. Докато MCM или Multi-Chip Module CPU могат да работят само със субстрат, както показват процесорите AMD Ryzen, алтернатива, особено използвана в по-ранните дизайни на чиплети, беше използването на interposer.
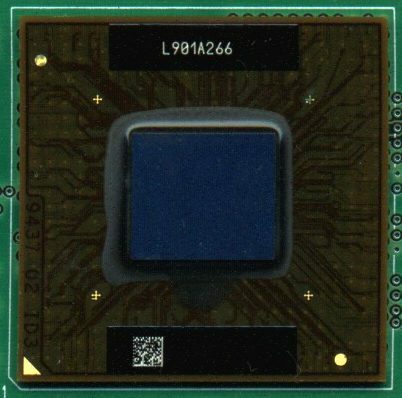
Интерпозерът е просто междинен слой между субстрата на пакета и матрицата на процесора. Interposer е направен от силиций, което го прави доста скъп, макар и не толкова скъп, колкото по-модерните техники за подреждане на 3D матрици. Силициевият междинен елемент обикновено е конфигуриран да се свързва към субстрата на опаковката чрез BGA или Ball Grid Array. Това е набор от малки топчета за спояване, което означава, че междинният елемент се държи физически над субстрата на опаковката, в сравнение с матрицата на процесора, която е директно слята към субстрата или интерпозера с електрическа свързаност, осигурена от мед стълбове. След това интерпозерът използва TSVs или Through Silicon Vias, за да прекара електрическите сигнали без влошаване. Силиконовият междинен елемент също така позволява комуникационна свързаност от матрица до матрица.
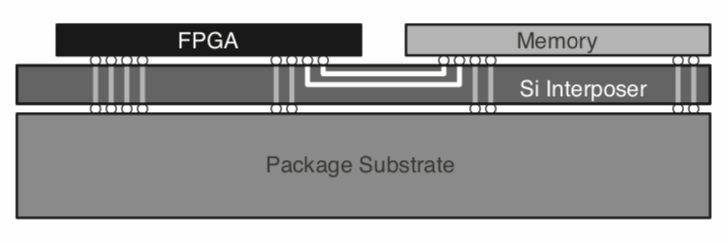
Ползи от използването на интерпосер
Интерпозерът предлага две основни предимства пред поставянето на матрицата на процесора директно върху субстрата на опаковката. Първо, силициевият междинен елемент има много по-нисък коефициент на топлинно разширение. Това означава, че могат да се използват по-малки изпъкналости, тъй като силиконът може да се справи с повишеното топлинно натоварване. Това също така означава, че I/O свързаността може да бъде значително по-плътна, отколкото при изграждане директно върху субстрата, което позволява по-висока честотна лента или по-добро използване на пространството на матрицата.
Второто предимство е, че силициевите междинни елементи могат да имат много по-тесни следи, гравирани в тях, отколкото може субстратът. Позволява по-плътна по-сложна схема. Друго предимство, което може да засегне само някои компании, е, че силициевият субстрат може да бъде гравиран с помощта на наследен хардуер за гравиране на CPU. Ако дадена компания вече разполага с този хардуер, който не се използва, той може да бъде използван повторно за тази цел. Съвременните малки процесни възли не са необходими, което означава, че хардуерните разходи за машините за ецване са минимални, поне в сравнение със съвременните производствени възли.
Заключение
Интерпозерът е посредник между субстрата на пакета и матрицата на процесора. Обикновено е направен от силиций. Предлага добра термична стабилност за връзки с малък мащаб и висока плътност. Тази функция е особено полезна за процесори, базирани на чиплети.