Eine Standard-CPU besteht aus drei Kernteilen. Dies sind das Substrat, der CPU-Chip und das IHS. Das Substrat ist die Leiterplatte, auf der der Rest der CPU platziert wird. An seiner Unterseite befinden sich die Anschlussstifte des CPU-Sockels. Der CPU-Die ist die eigentliche CPU. Es ist präzise geätztes Silizium, das die Verarbeitung durchführt. Der CPU-Die verfügt außerdem über direkt integrierte CPU-Cache-Tiers, um die Kommunikationszeiten zu minimieren. Der IHS ist der integrierte Heatspreader. Es drückt direkt auf den CPU-Die und leitet die entstehende Wärme an den CPU-Kühler weiter. Das IHS bietet auch Schutz vor Chip-Cracking. Der CPU-Die ist ziemlich spröde, und der Montagedruck des CPU-Kühlers könnte ihn brechen lassen. Das IHS neutralisiert dieses Risiko, da es diesen Druck nicht auf den CPU-Die überträgt.
Multi-Chip-Module
Das Gehäusesubstrat stellt die gesamte Konnektivität für den CPU-Chip bereit und leitet die elektrischen Signale von jedem der verwendeten Pins zum CPU-Chip. Leider funktioniert dies nicht ganz so gut, wenn mehrere Chips auf einer einzelnen CPU vorhanden sind. Dies kann daran liegen, dass sie eine Standard-Chiplet-Architektur verwenden oder dass das Design des Chips komplexer ist. Dies würde beispielsweise auch gelten, wenn die CPU ein FPGA oder einen Speicher direkt auf dem Gehäuse hätte. Während MCM- oder Multi-Chip-Modul-CPUs nur mit einem Substrat arbeiten können, wie AMDs Ryzen-CPUs zeigen, bestand eine Alternative, die insbesondere in früheren Chiplet-Designs verwendet wurde, darin, einen Interposer zu verwenden.
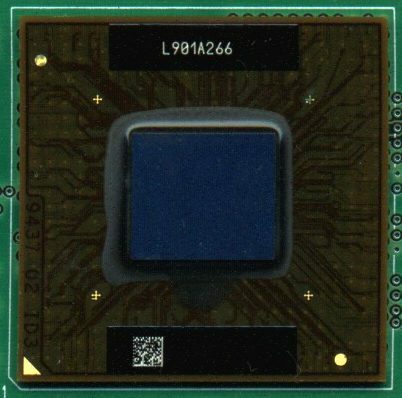
Ein Interposer ist einfach eine Zwischenschicht zwischen dem Gehäusesubstrat und dem CPU-Die. Der Interposer besteht aus Silizium, was ihn ziemlich teuer macht, wenn auch nicht so teuer wie modernere 3D-Die-Stacking-Techniken. Der Silizium-Interposer ist typischerweise so konfiguriert, dass er über ein BGA oder Ball Grid Array mit dem Gehäusesubstrat verbunden ist. Dies ist eine Anordnung kleiner Lötkugeln, was bedeutet, dass der Interposer physisch über dem Gehäusesubstrat gehalten wird. im Vergleich zum CPU-Die, der direkt mit dem Substrat oder Interposer verschmolzen ist, wobei die elektrische Konnektivität durch Kupfer bereitgestellt wird Säulen. Der Interposer verwendet dann TSVs oder Through Silicon Vias, um die elektrischen Signale ohne Beeinträchtigung durchzuleiten. Der Silizium-Interposer ermöglicht auch Chip-zu-Die-Kommunikationskonnektivität.
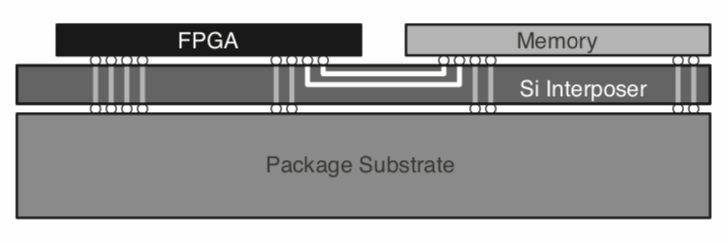
Vorteile der Verwendung eines Interposers
Ein Interposer bietet zwei Hauptvorteile gegenüber dem Platzieren des CPU-Chips direkt auf dem Gehäusesubstrat. Erstens hat der Silizium-Interposer einen viel niedrigeren Wärmeausdehnungskoeffizienten. Dadurch können kleinere Lotbumps verwendet werden, da das Silizium die erhöhte thermische Belastung verträgt. Dies bedeutet auch, dass die E/A-Konnektivität erheblich dichter sein kann als beim Aufbau direkt auf dem Substrat, was höhere Bandbreiten oder eine bessere Nutzung des Platzes auf dem Chip ermöglicht.
Der zweite Vorteil besteht darin, dass in Silizium-Interposer viel schmalere Spuren geätzt werden können als in das Substrat. Ermöglicht dichtere, komplexere Schaltungen. Ein weiterer Vorteil, der möglicherweise nur einige Unternehmen betrifft, besteht darin, dass das Siliziumsubstrat mit der Verwendung von Legacy-CPU-Ätzhardware geätzt werden kann. Hat ein Unternehmen diese Hardware bereits ungenutzt liegen lassen, kann sie für diesen Zweck wiederverwendet werden. Moderne kleine Prozessknoten werden nicht benötigt, was bedeutet, dass die Hardwarekosten für die Ätzmaschinen minimal sind, zumindest im Vergleich zu modernen Fertigungsknoten.
Fazit
Ein Interposer ist ein Vermittler zwischen dem Gehäusesubstrat und dem CPU-Die. Es besteht normalerweise aus Silizium. Es bietet eine gute thermische Stabilität für kleine Verbindungen mit hoher Dichte. Diese Funktion ist besonders nützlich für Chiplet-basierte CPUs.