Standarta centrālajam procesoram ir trīs galvenās daļas. Tie ir substrāts, CPU matrica un IHS. Substrāts ir PCB, uz kura ir novietots pārējais CPU. Tā apakšpusē ir CPU ligzdas savienotāja tapas. CPU mirst ir faktiskais CPU. Apstrādi veic precīzi iegravēts silīcijs. CPU veidnē ir arī tieši integrēti CPU kešatmiņas līmeņi, lai samazinātu komunikācijas laiku. IHS ir integrētais siltuma izkliedētājs. Tas nospiež tieši uz CPU matricas un pārraida radīto siltumu uz CPU dzesētāju. IHS piedāvā arī aizsardzību pret plaisāšanu. CPU matrica ir diezgan trausla, un CPU dzesētāja stiprinājuma spiediens var to saplaisāt. IHS neitralizē šo risku, jo tas nepārraida šo spiedienu uz CPU slēdzi.
Vairāku mikroshēmu moduļi
Iepakojuma substrāts nodrošina visu CPU matricas savienojumu, novirzot elektriskos signālus no katras izmantotās tapas uz CPU matricu. Diemžēl tas nedarbojas tik labi, ja vienam CPU ir vairāki matricas. Tas var būt tāpēc, ka viņi izmanto standarta mikroshēmas arhitektūru vai arī tāpēc, ka mikroshēmas dizains ir sarežģītāks. Piemēram, tas attiektos arī tad, ja centrālajam procesoram ir FPGA vai atmiņa tieši uz pakotnes. Lai gan MCM vai Multi-Chip Module CPU var strādāt tikai ar substrātu, kā liecina AMD Ryzen CPU, alternatīva, kas īpaši izmantota agrākos mikroshēmu projektos, bija starpposma izmantošana.
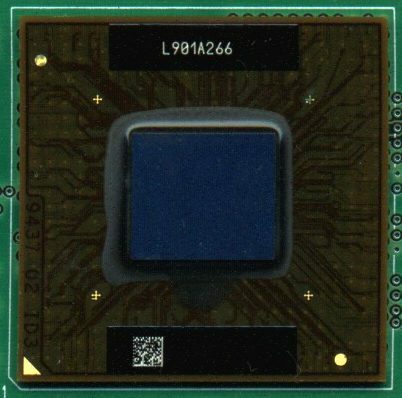
Interposer ir vienkārši starpslānis starp iepakojuma substrātu un CPU veidni. Interposer ir izgatavots no silīcija, kas padara to diezgan dārgu, lai gan ne tik dārgu kā modernākas 3D štancēšanas metodes. Silīcija starpposms parasti ir konfigurēts, lai izveidotu savienojumu ar iepakojuma substrātu, izmantojot BGA vai Ball Grid Array. Šis ir mazu lodēšanas lodīšu klāsts, kas nozīmē, ka starpnieks tiek fiziski turēts virs iepakojuma pamatnes, salīdzinot ar CPU matricu, kas ir tieši savienota ar substrātu vai starpliku ar elektrisko savienojumu, ko nodrošina varš pīlāri. Ievietotājs pēc tam izmanto TSV vai Through Silicon Vias, lai pārraidītu elektriskos signālus bez degradācijas. Silīcija interposer nodrošina arī nepārtrauktu sakaru savienojumu.
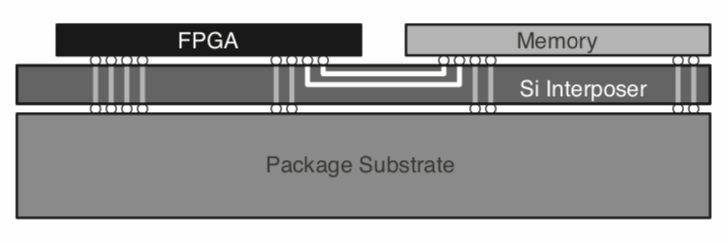
Starpposma izmantošanas priekšrocības
Interposer piedāvā divas galvenās priekšrocības salīdzinājumā ar CPU uzliktņa novietošanu tieši uz iepakojuma pamatnes. Pirmkārt, silīcija interposeram ir daudz zemāks termiskās izplešanās koeficients. Tas nozīmē, ka var izmantot mazākus lodēšanas izciļņus, jo silīcijs spēj izturēt palielināto termisko slodzi. Tas arī nozīmē, ka I/O savienojamība var būt ievērojami blīvāka nekā tad, ja tiek būvēts tieši uz pamatnes, tādējādi nodrošinot lielāku joslas platumu vai labāku brīvās vietas izmantošanu.
Otrs ieguvums ir tas, ka silīcija starpposmos var būt daudz šaurākas pēdas, kas iegravētas tajos nekā substrātā. Ļauj izveidot blīvāku un sarežģītāku shēmu. Vēl viena priekšrocība, kas var ietekmēt tikai dažus uzņēmumus, ir tā, ka silīcija substrātu var iegravēt, izmantojot mantoto CPU kodināšanas aparatūru. Ja uzņēmumam šī aparatūra jau ir neizmantota, to var izmantot atkārtoti šim nolūkam. Mūsdienu mazie procesa mezgli nav nepieciešami, kas nozīmē, ka kodināšanas iekārtu aparatūras izmaksas ir minimālas, vismaz salīdzinājumā ar mūsdienu ražošanas mezgliem.
Secinājums
Interposer ir starpnieks starp iepakojuma substrātu un CPU matricu. Parasti tas ir izgatavots no silīcija. Tas nodrošina labu termisko stabilitāti maza mēroga, augsta blīvuma savienojumiem. Šī funkcija ir īpaši noderīga procesoriem, kuru pamatā ir mikroshēmas.